Dopage (semi-conducteur) - Définition
La liste des auteurs de cet article est disponible ici.
Dopage de type N et de type P
Il existe deux types de dopage :
- le dopage de type N, qui consiste à produire un excès d'électrons, qui sont négativement chargés ;
- le dopage de type P, qui consiste à produire un déficit d'électrons, donc un excès de trous, considérés comme positivement chargés.
Les schémas suivants présentent des exemples de dopage du silicium respectivement par du phosphore (dopage N) et du bore (dopage P). Dans le cas du phosphore (à gauche), un électron supplémentaire est amené. Dans le cas du bore (à droite), il manque un électron ; c'est donc un trou d'électron qui est amené.

Dopage de type N |

Dopage de type P |
Technologies de dopage dans la micro-électronique
Il existe plusieurs méthodes pour effectuer le dopage d'un matériau :
- le dopage par diffusion ;
- l'implantation ionique ;
- le dopage par transmutation nucléaire.
Dopage par diffusion
Le dopage par diffusion peut être fait à partir :
- d'une source solide : l'échantillon à doper est placé dans l'enceinte. L'impureté est transportée jusqu'au matériau par un gaz vecteur inerte, à partir d'un composé solide qui se sublime. Exemple : P2O5 (dopage N du Silicium).
- d'une source liquide : le gaz vecteur barbote dans le liquide ou frôle sa surface à une température choisie. La pression partielle du composé dans le gaz est égale à la tension de vapeur du liquide. Exemple : POCl3 (dopage N du Silicium).
- d'une source gazeuse : le gaz contenant l'espèce dopante est introduit dans l'atmosphère. Exemples : PH3 (dopage N du Silicium), B2H6 (dopage P du Silicium), AsH3 (dopage N du Silicium).
Le dopage a lieu dans un four à diffusion, à une température comprise entre 850 °C et 1 150 °C, afin de permettre la diffusion des espèces dopantes dans le matériau.
Dopage par implantation ionique
Le dopage par implantation ionique consiste à accélérer des impuretés ionisées avec un champ électrique, afin de leur conférer l'énergie nécessaire pour rentrer dans le matériau à doper. Cette méthode permet d'utiliser une grande variété d'éléments dopants. Le faisceau mono-énergétique et la chambre sous vide rendent possible une grande reproductibilité et des dopages localisés.
Plus un ion est accéléré, plus son énergie cinétique est grande, et donc plus il s'enfoncera profondément dans le réseau cristallin du substrat que l'on dope. Ainsi, en contrôlant la dose et l'énergie, on détermine le profil de dopage.
L'un des inconvénients du dopage par implantation ionique est le fort desordre cristallin engendré par les chocs entre les ions incidents et les atomes du matériau. Cela engendre des défauts qui augmentent les probabilités de collision, et diminuent la mobilité des porteurs de charge.
Modification de la structure en bandes d'énergie
Le dopage provoque l'apparition de nouveaux niveaux accepteurs et donneurs d'électrons dans la structure de bande du matériau dopé. Ces niveaux apparaissent dans le gap, entre la bande de conduction et la bande de valence.
Lors d'un dopage N (schéma de gauche), l'introduction d'atomes donneurs d'électrons entraîne l'apparition d'un pseudo niveau d'énergie situé juste sous la bande de conduction. Ainsi, l'énergie nécessaire pour que les électrons passent dans la bande de conduction est bien plus facilement atteinte que dans un semiconducteur intrinsèque.
Lors d'un dopage P (schéma de droite), l'introduction d'atomes accepteurs d'électrons entraîne, de manière analogue, l'apparition d'un pseudo niveau situé au-dessus de la bande de valence. L'énergie à fournir aux électrons de valence pour passer sur ce niveau accepteur est faible, et le départ des électrons entraîne l'apparition de trous dans la bande de valence.

Dopage N |
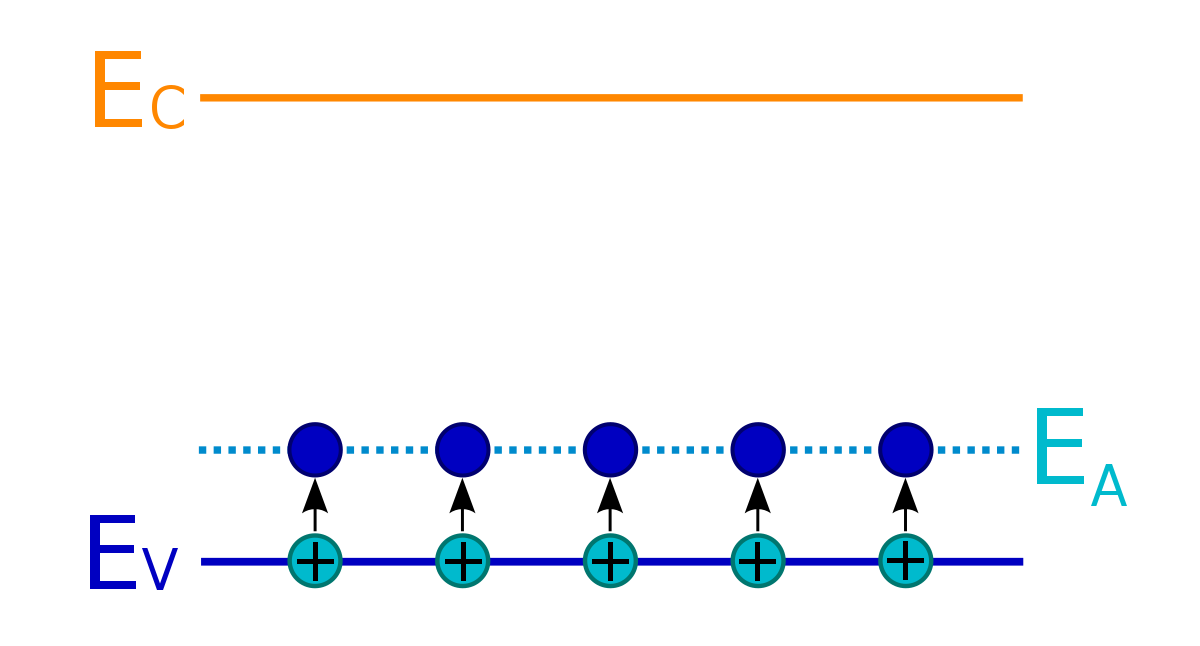
Dopage P |